
时间:2022-08-02 09:31:04来源:化工仪器网
今天,聚焦化工小新为大家分享来自化工仪器网的《《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》意见征求》。
碳化硅材料是一种宽禁带半导体,适合制备高电压、高功率、高频和高温半导体电子器件,在微波通讯、雷达、电力电子等领域具有广阔的应用前景,对国民经济和国防建设也具有重要意义。但是碳化硅中杂质元素含量对碳化硅材料的研制生产起着非常重要的作用,特别是半绝缘碳化硅中氮杂质元素的含量是其半绝缘性能的直接判定依据。
碳化硅中的杂质元素对研制生产起着重要的作用,故而为获得高纯半绝缘特性的碳化硅晶体,必须对杂质进行严格的控制。目前虽然许多生产和使用碳化硅材料的企业都对碳化硅中杂质含量测试提出了需求,但是尚无相关测试方法的标准或可借鉴的测试方法。为了改变这一情形,中国电子科技集团公司第四十六研究所起草编制了《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》。
《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》是按照GB/T 1.1-2020《标准化工作导则 第1部分:标准化文件的结构和起草规则》的规定起草的,其内容包括有范围、规范性引用文件、术语和定义、原理、干扰因素、试验条件、仪器设备、样品、试验步骤、试验数据处理、精密度、试验报告,规定了碳化硅单晶中硼、铝、氮杂质含量的二次离子质谱测试方法。
阅读标准征求意见稿后可知,二次离子质谱测试方法需要用到的仪器设备是扇形磁场二次离子质谱仪,其原理是在高真空条件下,氧或铯离子源产生的一次离子,经过加速、纯化、聚焦后,轰击碳化硅单晶样品表面,溅射出多种粒子,将其中的离子引出后,通过质谱仪将不同荷质比的离子分开,记录并计算样品中硼、铝、氮与硅的离子计数率之比后,即可利用相对灵敏度因子定量分析并计算出碳化硅单晶中的硼、铝、氮的含量。
鉴于碳化硅材料重要的战略地位,在我国也受到极大的关注,国家在碳化硅材料科研及产品产业化都投入了非常大的力量,近两年在国家重点研发计划项目中都布局了碳化硅专项。目前,《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》正面向社会征求意见,希望相关单位能在仔细研核后提出建设性意见,为标准的进一步完善添砖加瓦。
更多详情请点击:《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》征求意见稿
好了,关于“碳化硅”《碳化硅单晶中硼、铝、氮杂质含量的测量 二次离子质谱法》意见征求就介绍到这。
声明:文章仅代表原作者观点,不代表本站立场;如有侵权、违规,可直接反馈本站,我们将会作修改或删除处理。
图文推荐

2022-08-01 20:16:03

2022-08-01 18:50:02

2022-08-01 18:07:13

2022-08-01 18:07:02

2022-08-01 18:03:04
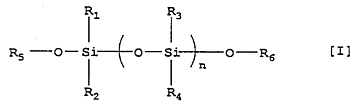
2022-08-01 17:03:07
热点排行
精彩文章

2022-08-02 09:03:38

2022-08-02 08:48:28

2022-08-02 08:48:06

2022-08-02 08:05:06

2022-08-01 20:59:07

2022-08-01 19:33:25
热门推荐
