
时间:2022-08-23 19:33:05来源:化工仪器网
今天,聚焦化工小新为大家分享来自化工仪器网的《《表面化学分析-二次离子质谱-硅中硼的深度剖析方法》意见征求》。
硼是半导体硅材料中的一种重要P型杂质元素,其在硅中浓度分布直接影响到硅材料及器件的性能,而二次离子质谱分析具有高灵敏度和较好的深度分辨本领,是检测硅中硼浓度随深度分布的有效手段。基于二次离子质谱的优良检测性能,ISO 17560-2014《表面化学分析-二次离子质谱-硅中硼深度剖析方法》早已发布。为了与接轨并促进国内相关技术的提升,促使我国二次离子质谱定量分析技术规范化,全国微束分析技术委员会表面分析分技术委员会提出将该标准转化为国家标准。
在中国电子科技集团公司第四十六研究所起草工作组对标准进行讨论和完善后,《表面化学分析-二次离子质谱-硅中硼的深度剖析方法》已于近日编制完成,并正面向社会征求意见。
据悉,该标准是依据GB/T 1.1-2009《标准化工作导则 第1部分:标准的结构和编写》和GB/T 20000.2-2009《标准化工作指南 第2部分:采用标准》等进行编制的,引用了GB/T 20176-2006《表面化学分析-二次离子质谱-二次离子质谱用均匀掺杂物测定硅中硼的原子浓度》、GB/T22461-2008《表面化学分析-词汇》,规定了用扇形磁场或四极杆式二次离子质谱仪对硅中硼进行深度剖析的方法,以及用触针式轮廓仪或光学干涉仪深度定标的方法。
阅读标准征求意见稿后可知,标准中规定的方法原理是用氧或铯离子束扫描样品表面,将在离子束扫描范围内一定窗口区域溅射出的硼和硅二次离子引出,对其进行质量分析和检测,将监测的信号强度作为溅射时间的函数。使用触针式轮廓仪或光学干涉仪,测量出离子束溅射形成坑的深度,以此标定深度。而实验需要的仪器有二次离子质谱仪、触针式轮廓仪和光学干涉仪。值得注意的是,实验过程中,在样品即将引入SIMS仪器前,应该用高纯压缩气体吹去样品表面的尘埃,待样品引入分析室后,直到真空度恢复到厂商或当地成文的步骤推荐的正常值时,分析才可以开始。
按照本标准测试,可得到硼在硅中浓度随深度分布直接、准确的定量测试结果,不但可以用于检验晶片质量,还可以有效的监控外延、离子注入、扩散、退火等器件工艺,这对于半导体领域科研生产有着重要意义。为此,希望相关单位在仔细研核后提出建设性意见,以提高标准的科学性和严谨性。
更多详情请点击:《表面化学分析-二次离子质谱-硅中硼的深度剖析方法》
好了,关于“离子”《表面化学分析-二次离子质谱-硅中硼的深度剖析方法》意见征求就介绍到这。
声明:文章仅代表原作者观点,不代表本站立场;如有侵权、违规,可直接反馈本站,我们将会作修改或删除处理。
图文推荐

2022-08-23 18:50:13

2022-08-23 18:50:02

2022-08-23 16:41:20

2022-08-23 16:41:09

2022-08-23 16:05:06

2022-08-23 14:32:02
热点排行
精彩文章

2022-08-23 18:07:17

2022-08-23 16:04:16

2022-08-23 15:58:07

2022-08-23 14:32:30

2022-08-23 14:32:17
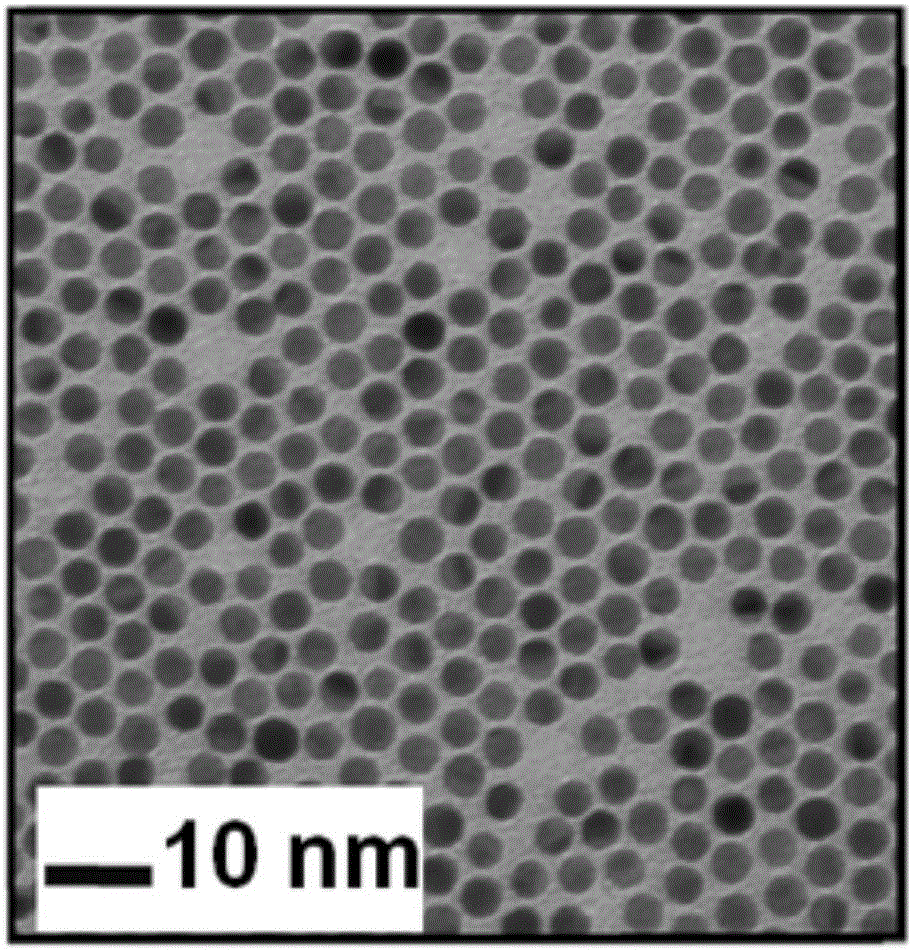
2022-08-23 14:02:51
热门推荐
