
时间:2022-08-30 10:57:42来源:化工仪器网
今天,聚焦化工小新为大家分享来自化工仪器网的《《硅片薄膜厚度的测试 光学反射法》意见征求》。
为了防止在外延过程中的自掺杂,通常会在硅片背表面生产一层氧化膜作为背封膜,而膜厚及其均匀性以对多晶层的质量及均匀性会直接影响集成电路后续工艺的成品率,故而需要对该工艺进行有序规范。
在半导体产业中,薄膜厚度测量是单晶硅晶圆表面介电材料和光刻胶等薄膜厚度及平整度质量控制的重要手段,测量方法也有很多,包括有光谱反射法、迈克尔逊干涉仪、椭圆偏振法、X 射线干涉法、β射线反射散射法、颜色比较法等,但很多方法在使用中受到许多条件的限制,测试过程也很复杂,不能满足实际生产快速准确的要求。为了改变这一情形,有研半导体材料股份有限公司根据《国家标准管理委员会关于下达第一批推荐性国家标准计划的通知》的要求,起草编制了《硅片薄膜厚度的测试 光学反射法》。
为确保标准的科学性、适用性和可行性,起草组是按照GB/T 1.1-2020《标准化工作导则 第1部分:标准化文件的结构和起草规则》的规定起草的,并引用了GB/T 14264《半导体材料术语》和GB/T 25915.1《洁净室及相关受控环境 第1部分:空气洁净度等级》。
阅读标准征求意见稿后可知,《硅片薄膜厚度的测试 光学反射法》规定了采用光学反射法测试硅片表面二氧化硅或多晶薄膜层厚度的方法,该方法需要用到的仪器设备包括有光源、具有可以接收反射光束的光谱仪、光纤和组合镜头、样品台和控制系统。
为确保实验顺利进行,标准中还指出了应对干扰因素的赢多方法:环境中强光、磁场、温度、湿度等波动对测试结果会造成影响,故而推荐在6级或以上的洁净实验室中进行实验操作;样品的表面粗糙度对测试结果存在影响,应对其做镜面抛光处理;样品表面的薄膜与作为样品衬底的材料有时候不能拟合出理想的曲线,需要在两者之间加一层其他材料;若测试薄膜的厚度不够,达不到一个周期的反射率振荡,可通过调节入射波长等条件达到理想的拟合曲线。
本标准将作为推荐性国家标准发布实施,相信其能有利于薄膜测试的简化和规范薄膜厚度的评价标准,促进行业的统一和对产品质量的把控,并助集成电路国有化的研究与发展一臂之力。
更多详情请点击:《硅片薄膜厚度的测试 光学反射法》征求意见稿
好了,关于“薄膜”《硅片薄膜厚度的测试 光学反射法》意见征求就介绍到这。
声明:文章仅代表原作者观点,不代表本站立场;如有侵权、违规,可直接反馈本站,我们将会作修改或删除处理。
图文推荐

2022-08-30 08:05:23

2022-08-29 12:23:13

2022-08-29 11:40:04

2022-08-29 10:57:12

2022-08-29 10:57:02

2022-08-29 10:14:14
热点排行
精彩文章
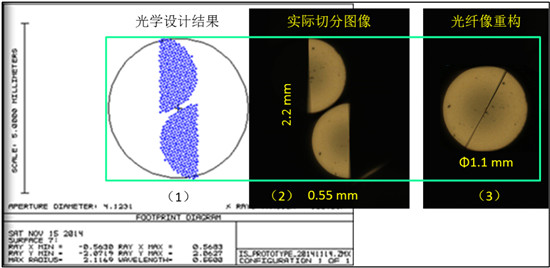
2022-08-30 10:14:27

2022-08-30 10:14:16

2022-08-30 09:31:18

2022-08-30 08:48:05

2022-08-30 08:05:27

2022-08-30 08:05:17
热门推荐
